1. CVD, PVD, ALD
CVD는 Chmical Vapor Deposition의 약자로, 화학적 증착방식을 말한다. PVD보다 빨리 나온 방법으로 화학적으로 막을 성장시키는 방식이다. PVD는 Physical Vapor Deposition의 약자로, 물리적 증착방식이다. 보통 열증착이나 플라즈마 증착방식으로 막을 형성시킨다. CVD, PVD의 공통점은 박막을 만들 때 두께가 단단위 나노미터로 얇게 하는데 한계가 있다는 점이다. ALD는 Atomic Layer Deposition의 약자로, 원자급 레이어를 형성할 수 있는 증착기술을 뜻한다. 원자층을 한층한층 쌓아올려 막을 형성하는 적층방식이기 때문에 나노미터급의 아주얇은 박막을 형성할 수 있다.

2.1 ALD 기본원리
1) 흡착단계 : 1차 소스(전구체)를 프로세스 챔버에 넣으면 먼저 표면 흡착이 일어난다.
2) 치환단계 : 다른 종류의 2차 소스(반응체)를 넣으면 1차 흡착된 물질과 화학적 치환이 일어난다.
3) 생성단계 : 최종적으로 제3의 신규물질(막)이 생성된다.
4) 배출단계 : 잔류 가스가 배출되어 결국 1개 층만 표면에 흡착되어 달라붙게 된다.
총 4개의 단개가 하나의 사이클로 계속해서 반복하여 layer 두께를 조절할 수 있다.

2.2 ALD 공정 과정(게이트 옥사이드 유전막)
Step1) 준비되어진 웨이퍼에 TMA[Al(CH3)3]를 공급하게 되면, TMA는 웨이퍼 표면과 반응을 하여 화학 흡착하게 된다. TMA가 표면에 원자층이 증착되어지면, 과잉의 TMA 반응 기체가 공급되어도 더 이상 반응을 하지 않게 된다. (자기 제한적 반응; Self-limiting Reaction)
Step2) TMA가 더 이상 반응을 하지 않은 상태에서 불활성 기체를 사용하여 과잉의 TMA 를 반응기 외부로 제거한다.
Step3) 반응기 내부에 TMA가 완전히 제거되어지면, H2O를 공급하게 되며, H2O는 표면과 흡착된 TMA와 반응을 하여 화학 흡착하게 된다. H2O가 표면에 포화 상태를 이루게 되면, 더 이상 반응을 하지 않게 된다. (자기 제한적 반응; Self-limiting Reaction)
Step4) H2O가 더 이상 반응을 하지 않은 상태에서 불활성 기체를 사용하여 과잉의 H2O 를 반응기 외부로 제거한다.

3.1 CVD, PVD와 ALD의 차이점
- CVD, PVD는 아날로그방식, ALD는 디지털 방식
- CVD, PVD는 20nm이하로 박막형성 어려움, ALD는 절연막 두께를 Xnm에서 1nm이하로 줄일 수 있음
- CVD, PVD는 여러 분자들이 한꺼번에 반응하여 막이 쌓이는 방식인 반면, ALD는 입력 소스들을 차례대로 공급하여 단원자나 분자층이 한 사이클 당 한개의 원자층이 쌓이도록 함
- CVD,PVD는 증착하여 박막을 쌓는 방식, ALD는 흡착방식으로 원자층을 쌓는 방식
3.2 ALD 특징
- PVD와 같은 물리적 방식이 아니고, CVD와 유사한 화학적 방식
- 갭이나 트랜치의 벽면에도 잘 달라 붙음
- 섭씨 400도 이하(200~400도)의 낮은 온도에서 공정진행이 가능
(1) ALD 장점
- 자기제어반응으로 단단위nano 미터급 두께 정밀히 쌓을 수 있음
- 층 내의 전체 격자가 정형적인 각을 이뤄서 질서정연하고 얇은 두께 형성
- 두께 조절에 획기적
- 낮은 온도에서 공정이 가능해 다른막에 영향을 거의 끼치지 않음
(2) ALD 단점
- 1개 사이클에 원자층이 1개 층씩만 쌓여 속도가 느림
- 저온에서 진행하여 막의 물성이 떨어짐
- 1차 소스와 2차 소스들을 선택하는 데 한정적임

4.1 ALD 활용
- DRAM의 커패시터
- 게이트 옥사이드
- 메탈 베리어(Metal Barrier)
- NAND의 3D(Cell stacking 구조)를 구성하는 가장 중요한 절연막/금속
4.2 최근 기술
- 속도를 높이는 방식으로 플라즈마 ALD, PEALD가 있음(ALD보다 낮은 온도에서 반응성 높일 수 있음)
- Loading 방식에서 Semi-batch Type이 개발되어 한꺼번에 여러 웨이퍼를 프로세싱 할 수 있음
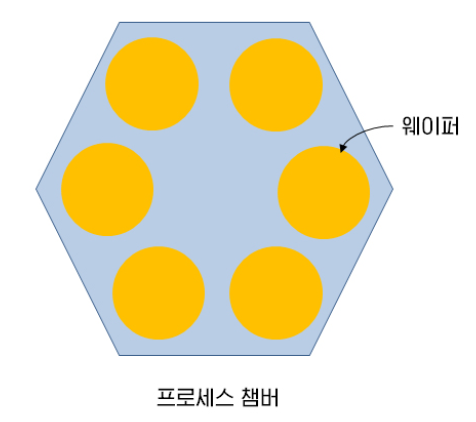
5. 참고자료
[1] 진종문, "ALD, 원자를 이용해 박막을 만드는 방법", Skhynix newsroom (2018)
[2] atmoic-layer-deposition, oxford instrument
[3] 황철주, "최천단 반도체에서의 ALD 증착 기술", 물리학과 첨단기술 (2012)
'반도체과제 박살내자!' 카테고리의 다른 글
| [반도체]박막증착공정 심화: CVD 온도에 따른 증착률(Deposition Rate) (0) | 2020.04.09 |
|---|---|
| [반도체]박막증착공정 기본: CVD(Chemical Vapor Deposition) (0) | 2020.04.09 |
| [반도체]박막측정장비: 라만 분광법(Raman Spectroscopy) (0) | 2020.04.07 |
| 2차원소재(2DLMs) (1) | 2020.04.07 |
| [서평]대학원생때 알았더라면 좋았을 것들(1)(엄태웅편) (0) | 2020.03.29 |



